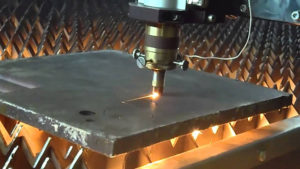 Лазерная резка из хрупких материалов, таких как керамика, полупроводники и стекла преодолевает трудности механической обработки с точкой зрения износа инструмента и скорости резания. Однако лазерная резка хрупких материалов часто может приводить к нежелательным микротрещинам, отклонению траектории реза и нежелательным тепловым эффектам, таким как повторная обработка, разбрызгивание и обломки. При лазерной резке хрупких материалов использовался ряд методов. Эти методы включают термическое испарение / выброс расплава и контролируемое разрушение. Объемное поглощение (с использованием лазерный луч, который частично прозрачен для разрезаемого материала), как было обнаружено, позволяет быстро разрезать прозрачные и полупрозрачные материалы путем образования единственной трещины при температурах значительно ниже температур плавления или фазового перехода. В результате «невидимая» резка с высококачественными резками без мусора и сколов может быть достигнут. Высокие температурные градиенты при лазерной резке хрупких материалов с низкой теплопроводностью создают термические напряжения, которые иногда могут приводить к нежелательным микротрещинам и отклонениям реза. Поэтому контроль тепловых воздействий при резке керамических, полупроводниковых, стеклянных материалов имеет решающее значение для успеха процесса резки. Моделирование развития напряжений и управление тепловым полем имеет решающее значение для успеха лазерной резки хрупких материалов.
Лазерная резка из хрупких материалов, таких как керамика, полупроводники и стекла преодолевает трудности механической обработки с точкой зрения износа инструмента и скорости резания. Однако лазерная резка хрупких материалов часто может приводить к нежелательным микротрещинам, отклонению траектории реза и нежелательным тепловым эффектам, таким как повторная обработка, разбрызгивание и обломки. При лазерной резке хрупких материалов использовался ряд методов. Эти методы включают термическое испарение / выброс расплава и контролируемое разрушение. Объемное поглощение (с использованием лазерный луч, который частично прозрачен для разрезаемого материала), как было обнаружено, позволяет быстро разрезать прозрачные и полупрозрачные материалы путем образования единственной трещины при температурах значительно ниже температур плавления или фазового перехода. В результате «невидимая» резка с высококачественными резками без мусора и сколов может быть достигнут. Высокие температурные градиенты при лазерной резке хрупких материалов с низкой теплопроводностью создают термические напряжения, которые иногда могут приводить к нежелательным микротрещинам и отклонениям реза. Поэтому контроль тепловых воздействий при резке керамических, полупроводниковых, стеклянных материалов имеет решающее значение для успеха процесса резки. Моделирование развития напряжений и управление тепловым полем имеет решающее значение для успеха лазерной резки хрупких материалов.
Метод двойного лазерного луча был предложен Цзяо и Ван 87 для резки стеклянных подложек с целью улучшения качества резки. Они использовали сфокусированный луч CO 2 -лазера для рисования прямой линии на подложке, а затем был использован несфокусированный луч CO 2 -лазера для облучения линии скрайбирования для создания растягивающего напряжения и разделения различных частей подложки. Они использовали программное обеспечение ANSYS для метода конечных элементов (МКЭ) для расчета распределения температуры и результирующего поля термических напряжений.






